Hochauflösendes XRD (HR-XRD) ist eine gängige Methode zur Messung der Zusammensetzung und Dicke von Verbindungshalbleitern wie SiGe, AlGaAs, InGaAs usw.
Wenn Dotierstoffe oder Verunreinigungen zu einem hinzugefügt werdenEinkristallWenn Sie das Gitter verschieben, wird das Gitter aufgrund der Anwesenheit von Dotierungsatomen gedehnt. In einem Si-Gitter beispielsweise verursacht das Vorhandensein von Ge-Atomen eine Druckspannung, da die Ge-Atome im Gitter größer sind als die Si-Atome. Diese Spannung verändert den Abstand des Si-Gitters und dieser Abstandsunterschied kann durch HR-XRD nachgewiesen werden.

Abbildung 1: Theoretisches HR-XRD-Scannen einer allgemeinen Struktur unter Druckspannung, beispielsweise einer 10 nm dicken SiGe-Schicht auf einem Si-Substrat. Die Spitzen bei 0 Grad stammen vom Si-Gitter im Substrat.
Das Vorhandensein größerer Ge-Atome führt dazu, dass die Si-Atome in der SiGe-Schicht weiter voneinander entfernt sind, wodurch sich der Beugungspeak in einen kleineren Winkel verschiebt (nach links vom Substratpeak). Da die 10-nm-SiGe-Schicht dünner ist, ist der Beugungspeak der SiGe-Schicht viel breiter als der des Si-Substrats.
In solchen Filmen können nur wenige Atomreihen mit einer bestimmten Anordnung verwendet werden, um ein Beugungssignal zu erzeugen, und dasRöntgenbeugungDer Peak ist breiter als die Beugung an einem Si-Substrat, da das Substrat Tausende von Reihen enthält, die zur Erzeugung der atomaren Sequenz von Beugungssignalen verwendet werden können. Wenn die Struktur unter Zugspannung steht, sind die Si-Atome enger voneinander entfernt als die Si-Atome im Substrat und der entsprechende Beugungspeak bewegt sich nach rechts vom Substratpeak. Die zusätzlichen Peaks im Spektrum, genannt"Dicke Streifen,"entstehen durch verstärkte Interferenz von Röntgenstrahlen, die an der Grenzfläche zwischen der SiGe-Schicht und dem Si-Substrat reflektiert werden. Dabei handelt es sich um dasselbe Signal, das auch für die Röntgenreflexionsanalyse (XRR) verwendet wird und zur Bestimmung der Dicke der Dehnungsschicht verwendet werden kann.
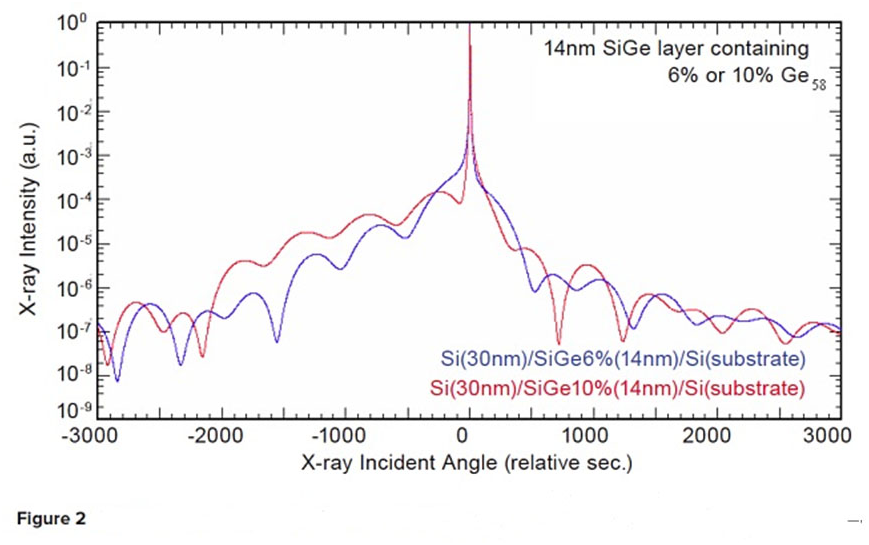
Mit dieser Methode kann die Zusammensetzung der Dehnungsschicht bestimmt werden. Abbildung 2 zeigt einen theoretischen HR-XRD-Scan von zwei Proben, die aus 30 nm dickem Si auf 14 nm dickem SiGe auf einem Si-Substrat gewachsen sind. Im ersten Fall befinden sich 6 % Ge im Gitter, im anderen Fall sind es 10 % Ge. HR-XRD kann den Unterschied zwischen diesen beiden Strukturen leicht erkennen und die Dicke der Schicht anhand des Dickenstreifens bestimmen.
Darüber hinaus ermöglichen fortschrittliche Modellierungstechniken eine genaue Beschreibung von Strukturmerkmalen, wie z. B. SiGe-Schichten mit abgestuften Strukturen. HR-XRD kann eine Vielzahl epitaktischer Materialien wie AlGaAs, InGaAs, InGaN usw. messen. Im Allgemeinen gilt:XRDkann die Zusammensetzung dieser dünnen Filmschichten mit einer Genauigkeit von weniger als 1 % bestimmen. Es ist jedoch zu beachten, dass HR-XRD davon ausgeht, dass alle Dotierungsatome im Gitter vorhanden sind.





