
Anwendung der XRD-Technologie in der Halbleiterindustrie
2023-09-20 10:00Die weltweiten Ausgaben für Halbleiterausrüstung sind in einen Aufwärtstrend eingetreten. Die Anwendung neuer Technologien und neuer Produkte wie 5G, Internet der Dinge, Big Data, künstliche Intelligenz und Automobilelektronik wird eine enorme Nachfrage auf dem Halbleitermarkt mit sich bringen und die Branche wird in eine neue Runde des Wachstumszyklus eintreten. Waferproduktion, Epitaxiewachstum, Verpackung und Integration am vorderen Ende der gesamten Industriekette sowie deren Prozess- und Produktqualität stehen in direktem Zusammenhang mit nachgelagerten Industrieanwendungen. Rigaku verfügt über ein komplettes Ausrüstungssystem, wie zRöntgenbeugung(XRD), Röntgenfluoreszenz (RFA), Röntgenreflektometer (XRR) und Röntgentopographie (XRT), die auf den gesamten Prozess von der Waferproduktion bis hin zu integrierten Schaltkreisen angewendet werden können und eine zerstörungsfreie Messung einer Reihe wichtiger Prozessparameter ermöglichen, wie z. B. der Dicke , Zusammensetzung, Rauheit, Dichte, Porosität sowieKristallstrukturund Kristallstrukturdefekte.
1. Bei der Waferproduktion haben Anzahl und Art der Defekte großen Einfluss auf die nachfolgenden Schritte. Mithilfe der topologischen Röntgenbildgebung (XRT) können Defekte und Versetzungen auf der Waferoberfläche deutlich beobachtet werden (Abbildung 1). Helfen Sie den Produzenten, den Prozess zu verbessern und die Qualität zu kontrollieren.
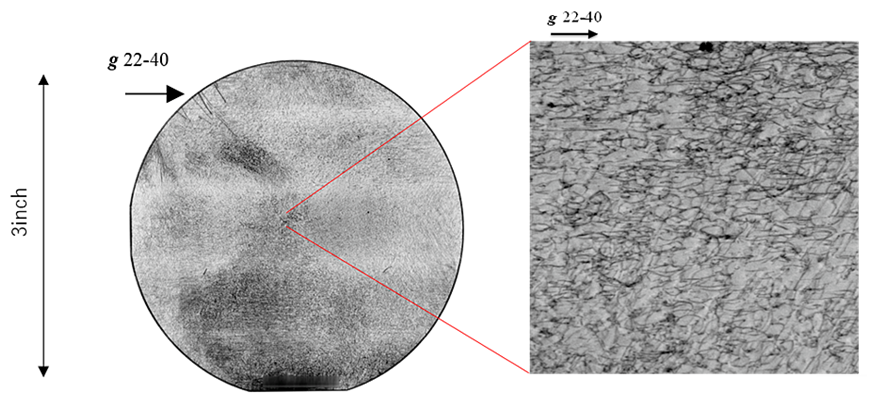
Abbildung 1: Abbildung der Transmissionstopologie eines 4H-sic-Wafers
2. Die Gleichmäßigkeit von Wafern oder epitaktischen Filmen kann gemessen werden durchXRDDie Schwungkurvenfunktion und das von Rigaku bereitgestellte Visualisierungssoftwaremodul können auch zweidimensionale Verteilungsbilder liefern, mit denen die Qualität der Oberfläche intuitiv beurteilt werden kann (Abbildung 2).
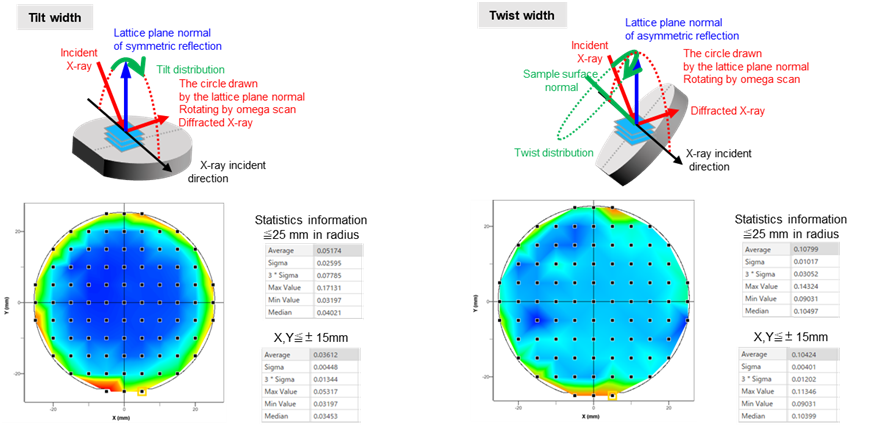
Abbildung 2: Zweidimensionales Bild des AlN-Films, der auf einem Saphirsubstrat wächst
3. Die Dicke des Films kann mithilfe einer hochauflösenden Schwingkurve gemessen werden, die zerstörungsfrei und äußerst genau ist (Abbildung 3).

Abbildung 3: Hochauflösende Swing-Kurve zur Messung der Dicke von GaN/InxGa(1-x)N-Filmen
4. Während des Wafer- oder Epitaxiefilmwachstums kann es zu einer Gitterfehlanpassung kommen, die sich auf die Qualität des Films auswirkt. Mit den speziellen Detektoren und Lösungen von Rigaku können im SmartLab reziproke Weltraumtests durchgeführt werden, bei denen Gitterfehlanpassungen undkristallographischKonstanten können sehr intuitiv gesehen werden.
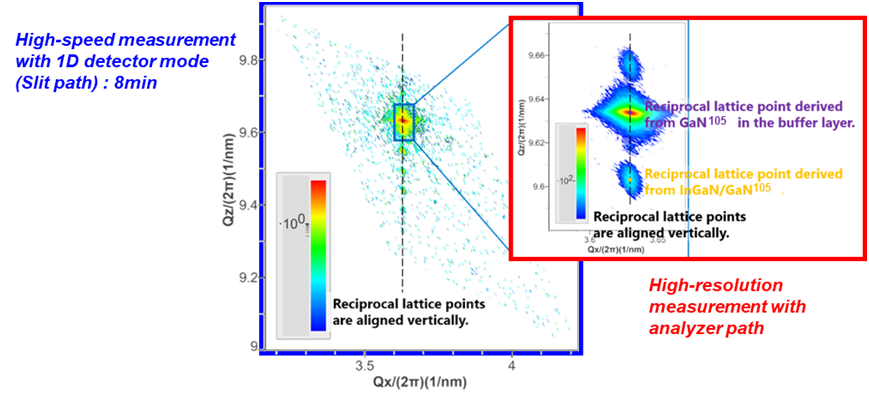
Abbildung 4: hochauflösendes reziprokes räumliches Spektrum von GaN105
